電子ビーム励起プラズマ(Electron Beam Exited Plasma System)

制御された電子ビームを用いてプラズマ空間を制御・プロセスガスの超高解離を実現した高速・高品質表面処理(成膜・エッチング・表面改質)装置。
特徴
- 低圧力領域においてエネルギー可変電子ビームにより、プロセスガスを高効率に解離、電離を行なうことができ、高密度の活性種を生成することが可能
(圧力:10-2~1Pa 電子密度:~1012cm-2)
⇒CCPプラズマ、ICPプラズマでは達成できないプラズマ状態を生成
⇒様々な材料の密度成膜、エッチング、表面改質が可能 - φ100mmの酸化物、金属、樹脂等の成膜表面改質に対応
- ステージ加熱(Max 500℃)、バイアス印加による高速高精度処理が容易
EBEP(電子ビーム励起プラズマ源)とは
従来のプラズマ発生方法では、外部から電力(DC,AC,RF,μ波等)を導入する為、プラズマガスの電離によってよって生じた電子のみがプラズマ中に存在しています。その為、プラズマパラメータはガス流量・圧力、及び外部電力の種類等に依存していました。これに対してEBEPは制御された電子ビームをプラズマ反応空間中に直接打ち込むことにより、プラズマガスを電離させます。これにより、プラズマパラメータを直接的に制御することができます。
※電子ビーム励起プラズマ源は、(独)理化学研究所の特許の実施権を取得して改良を加え、装置化したものです。
EBEP(電子ビーム励起プラズマ源)概略図
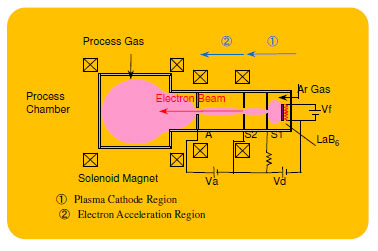
適用例
- 高速窒化処理(難窒化材にも適用可)
- 機能性膜(BN膜 等)
- 酸化膜エッチング
- カーボン膜(DLC,ダイヤモンド膜)
- ナノカーボン膜(CNT,CNW)
- Si膜
- 酸化膜 他
標準仕様
主寸法(電源盤、制御盤含まず)・・・幅1,800mm×奥行き1,200mm×高さ1,750mm)
| EBEB本体 |
構成
排気系
|
EBEP本体
電源
排気系
収束コイル
水冷シャッター
TMP(300・s)+ ドライポンプ
|
一式 |
|---|---|---|---|
| プロセスチャンバー |
材質
構造
真空到達度
ヒータ
|
SUS304
φ300 x H300mm
<5x10-5Pa
パネルヒータ
|
一式 |
| 基盤ステージ (本体形状) |
バイアス
標準対応サイズ
加熱温度
|
印加可能
Max Φ 100mm
Max500℃
|
一式 |
| 真空排気系 |
真空ポンプ
真空計
圧力制御
付属
|
TMP(1000・s)+ ドライポンプ
キャパシタンスマノメーター
電離真空計
圧力調整弁
大型ゲートバルブ
高真空アングルバルブ
配管 等
|
一式 |
| ガス供給系 |
系統数
その他
|
プロパセガス
N2パージ
パルプ・配管 等
|
五系統
一系統
一式
|
※性能向上の為、外観・使用は予告無く変更することがあります。
仕様に関するご要望等ございましたら、お気軽にご相談下さい。
その他オプション
- 制御版成膜レシピ…成膜レシピとして、事前に装置にパッケージ化
- ステージ機構…Roll To Roll方式、自転公転機構等にも適用化






