CCP型プラズマエッチング装置

高精度かつ高信頼性の酸化膜微細加工を実現する平行平板型エッチング装置。超大規模集積回路(ULSI)のSiO2コンタクトホールやSiOCH, 有機系材料による低誘電率薄膜(low-k)エッチングに使用する。
特徴
- プロセスガスからラジカルを選択的に生成
- 低電子温度、高密度プラズマが得られる60MHzパワーを上部電極に印加→イオンエネルギーを高精度に制御するため2MHzを下部電極に印加(オプション)
- 常に最適なエッチングプロセス条件が維持されるシーケンスプログラムを内蔵→エッチング処理毎のクリーニング処理(O2)により、電極やチャンバー壁についたフロン系膜を除去
CCP型プラズマエッチング装置とは
超大規模集積回路(ULSI)のSiO2コンタクトホールやSiOCH,有機系材料による低誘電率薄膜(low-k)エッチングでは、平行平板プラズマ装置にフロン系ガスを導入したプラズマエッチング技術が開発され、高精度のナノ寸法加工が実現されています。プラズマエッチング装置は、多種多様なものが用いられていますが、このようなフロン系ガスを用いたシリコン系の酸素膜エッチングには、平行平板エッチング装置が世界の標準となっています。
平行平板型エッチング装置概略図
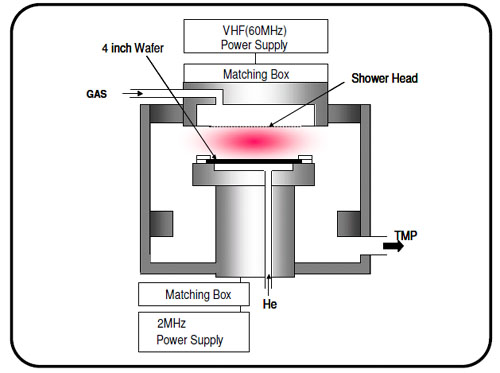
概要
外観寸法(制御系・ガス系は除く)・・・幅2,000mm×奥行き2,000mm×高さ2,000mm
1)CCP型2周波エッチング装置
| プロセスチャンバー |
材質
寸法
壁面ヒーター
対応基盤サイズ
到達真空度
|
SUS304
φ300 x H300mm
常温~100℃
φ4インチ 1枚
10-2Pa台
|
一式 |
|---|---|---|---|
| 基盤ステージ |
冷却方式
仕様冷媒温度
基盤保持
RFバイアス
|
冷媒循環及びHe
-20~60℃
静電チャック
2MHz 500W
|
一式 |
| 上部電極 |
RF電源
電極
使用冷媒温度
|
60MHz 1000W
冷却機能付きシャワーヘッド電極
20~60℃
|
一式 |
| 真空排気系 |
真空ポンプ
真空計
圧力制御
付属
|
TMP(800・s)+ ドライポンプ p
電離真空計
キャパシタンスマノメーター
ゲートバルブ
高真空アングルバルブ
配管 等
|
一式 |
| 制御系 |
インターロック
電源操作盤
|
有
PLC制御、タッチパネル方式
|
一式 |
2)ロードロックチャンバー
| チャンバー |
材質
対応基盤サイズ
輸送系
|
SUS304
φ4インチ 1枚
自動搬送
|
一式 |
|---|---|---|---|
| 排気系 |
真空ポンプ
真空計
付属
|
TMP(50l/s)+ ロータリーポンプ
電離真空計
高真空アングルバルブ
配管 等
|
一式 |
3)ガス供給系
| ガス供給系 |
系統数
輸送系
|
プロパセガス
N2パージ
パルプ・配管 等
|
五系統
一系統
一式
|
|---|
4)チラーユニット
| 下部冷却 |
冷却能力
温度制御範囲
|
1000W
-20~200℃
|
一式 |
|---|---|---|---|
| 上部冷却 |
冷却能力
温度制御範囲
|
500W
20~60℃
|
一式 |
※性能向上の為、外観・使用は予告無く変更することがあります。
仕様に関するご要望等ございましたら、お気軽にご相談下さい。
その他オプション
- 発行分光装置
- フィードバック制御インターフェイス等






